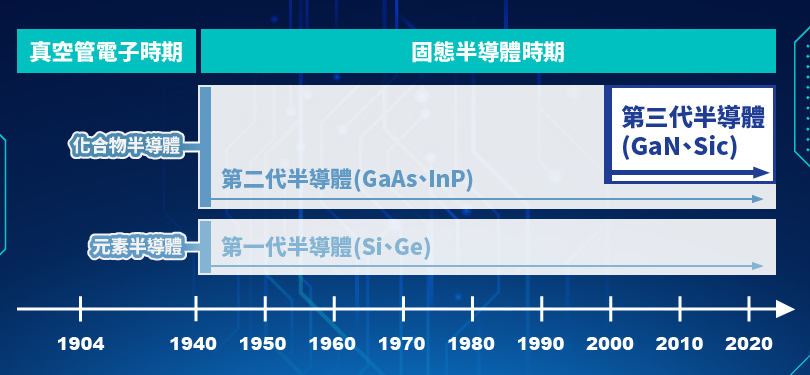

第三代半导体是目前高科技领域最热门的话题,在5G、电动车、再生能源、工业4.0发展中扮演不可或缺的角色,即使常听到这些消息,相信许多人对它仍一知半解,那么第三代半导体到底是什么?对此,本系列专题将用最浅显易懂、最全方位的角度,带你了解这个足以影响科技产业未来的关键技术。
第三代半导体、宽带隙是什么?
讲到第三代半导体,首先简单介绍一下第一、二代半导体。在半导体材料领域中,第一代半导体是「硅」(Si),第二代半导体是「砷化镓」(GaAs),第三代半导体(又称「宽带隙半导体」,WBG)则是「碳化硅」(SiC)和「氮化镓」(GaN)。
宽带隙半导体中的「带隙」(Energy gap),如果用最白话的方式说明,代表着「一个能量的差距」,意即让一个半导体「从绝缘到导电所需的最低能量」。
第一、二代半导体的硅与砷化镓属于低带隙材料,数值分别为1.12 eV(电子伏特)和1.43 eV,第三代(宽带隙)半导体的带隙,SiC和GaN分别达到3.2eV、3.4eV,因此当遇到高温、高压、高电流时,跟一、二代比起来,第三代半导体不会轻易从绝缘变成导电,特性更稳定,能源转换也更好。
一般人常有的第三代半导体迷思
随着5G、电动车时代来临,科技产品对于高频、高速运算、高速充电的需求上升,硅与砷化镓的温度、频率、功率已达极限,难以提升电量和速度;一旦操作温度超过100度时,前两代产品更容易故障,因此无法应用在更严苛的环境;再加上全球开始重视碳排放问题,因此高能效、低能耗的第三代半导体成为时代下的新宠儿。
第三代半导体在高频状态下仍可以维持优异的效能和稳定度,同时拥有开关速度快、尺寸小、散热迅速等特性,当芯片面积大幅减少后,有助于简化周边电路设计,进而减少模组及冷却系统的体积。
很多人以为,第三代半导体与先进制程一样,是从第一、二代半导体的技术累积而来,其实不尽然。从图中来看,这三代半导体其实是平行状态,各自发展技术。

SiC 和 GaN 各具优势、发展领域不同
了解到前三代半导体差异后,我们接着聚焦于第三代半导体的材料——SiC和GaN,这两种材料的应用领域略有不同,目前GaN组件常用于电压900V以下之领域,例如充电器、基站、5G通讯相关等高频产品;SiC则是电压大于1200 V,比如电动车相关应用。
SiC 是由硅(Si)与碳(C)组成,结合力强,在热量上、化学上、机械上都稳定,由于低耗损、高功率的特性,SiC 适合高压、大电流的应用场景,例如电动车、电动车充电基础设施、太阳能及离岸风电等绿色能源发电设备。
另外,SiC 本身是「同质磊晶」技术,所以品质好、组件可靠度佳,这也是电动车选择使用它的主因,加上又是垂直元件,因此功率密度高。
现今电动车的电池动力系统主要是200V-450V,更高端的车款将朝向800V发展,这将是SiC的主力市场。不过,SiC 晶圆制造难度高,对于长晶的源头晶种要求高,不易取得,加上长晶技术困难,因此目前仍无法顺利量产,后面会多加详述。

GaN 为横向组件,生长在不同基板上,例如 SiC 或 Si 基板,为「异质磊晶」技术,生产出来的 GaN 薄膜品质较差,虽然目前能应用在快充等民生消费领域,但用于电动车或工业上则有些疑虑,同时也是厂商极欲突破的方向。
GaN 应用领域则包括高压功率器件(Power)、高射频组件(RF),Power 常做为电源转换器、整流器,而平常使用的蓝牙、Wi-Fi、GPS 定位则是 RF 射频元件的应用范围之一。
若以基板技术来看,GaN 基板生产成本较高,因此GaN 组件皆以硅为基板,目前市场上的GaN功率元件以GaN-on-Si(硅基氮化镓)以及GaN-on-SiC(碳化硅基氮化镓)两种晶圆进行制造。
一般常听到的GaN制程技术应用,例如上述的GaN RF射频器件及PowerGaN,都来自GaN-on-Si的基板技术;至于GaN-on-SiC基板技术,由于碳化硅基板(SiC)制造困难,技术主要掌握在国际少数厂商手上,例如美国科锐(Cree)、II-VI及罗姆半导体(ROHM)。

▲ 射频组件、Power GaN 都来自 GaN-on-Si 技术
磊晶技术困难、关键SiC基板由国际大厂主导
第三代半导体(包括SiC基板)产业链依序为基板、磊晶、设计、制造、封装,不论在材料、IC设计及制造技术上,仍由国际IDM厂主导,代工生存空间小,目前台湾地区的供货商主要集中在上游材料(基板、磊晶)与晶圆代工。

▲ 第三代半导体的晶圆制程
从技术层面来看,GaN-on-Si和GaN-on-SiC有不同问题待解决,除了制程困难、成本高昂外,光是材料端的基板、磊晶技术难度就高,因此未能放量生产。GaN-on-Si制程要将氮化镓磊晶长在硅基材上,有晶格不匹配的问题须克服。
至于GaN-on-SiC的关键材料SiC基板,制程更是繁杂、困难,过程需要长晶、切割、研磨。生产SiC的单晶晶棒比Si晶棒困难,时间也更久,Si长晶约3天就能制出高度200公分的晶棒,但SiC需要7天才能长出2到5公分的晶球,加上SiC材质硬又脆,切割、研磨难度更高。
目前SiC基板主要由Cree、II-VI、英飞凌(Infineon)、意法半导体(STM)、ROHM、三菱电机(Mitsubishi)、富士电机(Fuji Electric)等国际大厂主导,以6吋或8寸晶圆为主;台厂则以4寸为主,6吋晶圆技术尚未规模化生产。
许多国家将SiC材料视为战略性资源,代工厂要取得相对困难,原料价格也高;相较于SiC、GaN-on-Si可用于车用市场和快充,GaN-on-SiC应用方向不够明确,因此全力投入开发仍需要一段时间。